
Samsung, Samsung Foundry Forum 2024’teki duyurusuyla birlikte bu yıl yüksek bant genişliğine sahip bellek (HBM) teknolojileri için 3D paketleme hizmetleri sunacağını söyledi. Şirket 3D paketleme için SAINT (Samsung Advanced Interconnect Technology) adı verilen ve üç farklı 3D istifleme teknolojisini içeren bir platforma sahip.
SRAM için SAINT-S, mantık için SAINT-L ve CPU ya da GPU gibi mantık çiplerinin üzerine DRAM istiflemek için SAINT-D olmak üzere yeni platform üç çözümden oluşuyor. İsmi ilk kez 2022 yılında anılan SAINT-D üzerindeki çalışmalar birkaç yıldır sürüyordu. Takvim yaprakları 2024 yılını gösterirken bu yıl içinde çalışmalar bir sonuca varacak gibi görünüyor. Bu da dünyanın en büyük bellek üreticisi ve önde gelen dökümhanelerinden olan Samsung için önemli bir kilometre taşı olacak.

Yeni 3D paketleme yöntemi sayesinde HMB yongalar işlemcilerin üzerine dikey şekilde istiflenebilecek. Ancak yeni tekniğin HBM yongalarını ve GPU’ları bir silikon ara parça aracılığıyla yatay olarak bağlayan mevcut 2.5D teknolojisinden farklı olduğunu belirtelim.
3D paketleme teknolojisi HBM için daha hızlı veri aktarımı, daha temiz sinyaller, daha az güç tüketimi ve daha düşük gecikme süreleri gibi önemli avantajlar sunuyor. Avantaj çok olsa da, paketleme maliyetlerinin yüksek olduğunu da belirtelim.
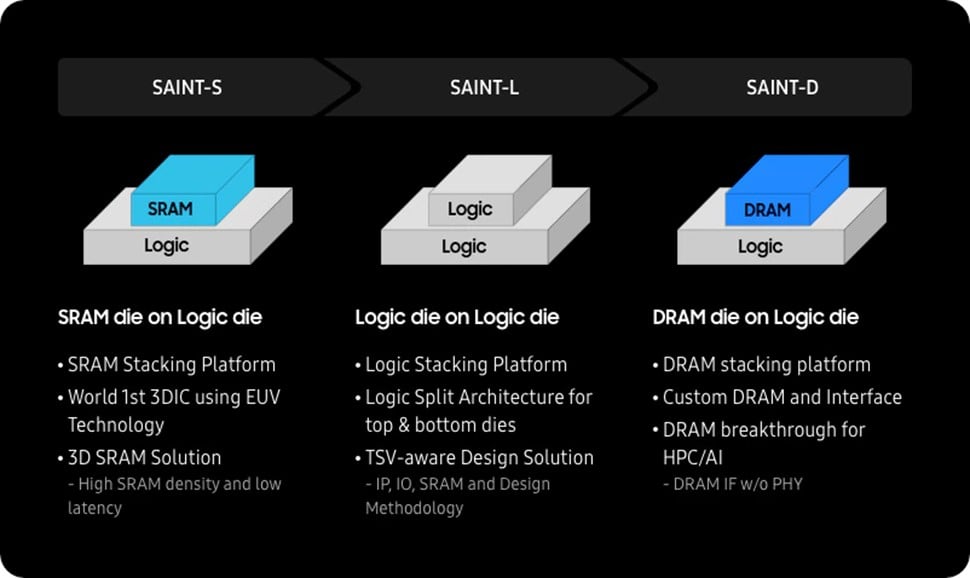
Güney Koreli devin bu yıl SAINT-D ile tam olarak ne sunmayı planladığını kimse bilmiyor. HBM’yi bir mantık kalıbına yerleştirmek için uygun bir çip tasarımı gerekiyor. Bu bağlamda, tanınmış şirketlerin HBM’yi üstte tutacak şekilde tasarladığı özel bir işlemciden haberdar değiliz. En azından bu yıl için böyle bir plan yok.



